《炬丰科技-半导体工艺》光刻胶清洁工艺
书籍:《炬丰科技-半导体工艺》
文章:光刻胶清洁工艺
编号:JFKJ-21-379
作者:炬丰科技
摘要
研究了使用基于硫酸的化学品去除光刻胶灰化残留物。样品是通过离子注入图案化的、紫外线硬化的光刻胶制备的。通过测量有机物、金属和颗粒表面浓度来确定灰后清洁的功效。硫酸-硝酸混合物和硫酸-过氧化氢混合物对于去除金属污染物非常有效。这两种化学方法对微粒和有机残留物都不是很有效。当基于硫酸的清洁后跟 RCA 类型的工艺顺序时,观察到高效的整体清洁。冗余清理没有提供额外的好处。通过减少基于硫酸的清洁次数,或者对于某些后灰应用,可以通过用 RCA 型工艺代替它们来简化后灰清洁。
介绍
氧化化学物质已被用于剥离光刻胶和作为光刻胶后的灰化清洁剂使用多年。这些氧化化学物质通常基于硫酸,并结合强氧化剂,例如过氧化氢或硝酸。尽管已经进行了大量研究来评估这些基于硫酸的化学物质去除光刻胶的功效,但在公开文献中关于使用这些化学物质进行灰后清洁的信息相对较少。之前关于光刻胶剥离的大部分工作都集中在优化硫酸化学的混合比以实现最大绝热温度。这种优化技术可能适用于去除体光刻胶。
实验性
样品制备
许多因素已知会影响或被认为会影响光刻胶灰化的功效。这些因素包括植入物种类和剂量、光刻胶厚度和轨道烘烤条件、紫外线稳定参数,也许最重要的是用于执行光刻胶灰化的工具和工艺参数。为这项研究准备的所有晶片都是 150 毫米监控级硅,上面已经生长了 10 纳米的屏蔽氧化物。氧化后,旋涂光刻胶,使用掩模版测试结构掩模或 CMOS 工艺层掩模在 I 线步进机上曝光,并显影轨迹。最后,晶片在紫外线稳定剂中固化,注入不同剂量和能量的 75As+ 或 31P+,并在下游的氧等离子体灰化器中灰化。
清洁实验 略
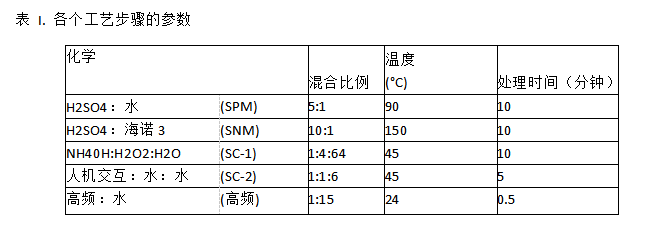
结果与讨论
在最初的筛选实验中,晶片用光罩测试结构掩模进行光刻,注入不同剂量的砷,并使用未优化的灰化配方剥离。在灰化之后,通过 5:1 SPM 化学处理晶片。这导致在 Tencor Surfscan7700 上测量的光散射事件计数没有实质性变化。
结论
优化灰化后清洁的考虑因素与优化光刻胶剥离的考虑因素大不相同。对于灰后清洁,需要去除痕量金属污染物、微粒和分子有机物,而不是去除大量的重有机材料。硫酸基化学品通常在光刻胶灰化后使用,事实上,经常重复进行,并与其他清洁化学品一起使用。由于这些清洁剂可有效去除金属污染物,因此它们为灰后清洁提供了益处。
